常规制造能力:
|
序号No |
项目ltem |
技术能力参数Process capability parameter |
|
|
1 |
基材 Base material |
FR-4|High Tg|Halogen-free|PTFE|Ceramic PCB|Polyimide| |
|
|
2 |
印制板类型 PCB type |
PCB|FPC|R-FPC|HDI |
|
|
3 |
最高层次 Max layer count |
40层 40 layers |
|
|
4 |
最小基铜厚 Min base copper thickness |
1/3 OZ (12um) |
|
|
5 |
最大完成铜厚 Max finished copper thickness |
6 OZ |
|
|
6 |
最小线宽/间距 Min trace width/spacing |
内层 Inner layer |
2/2mil (H/H OZ base copper) |
|
7 |
外层 Outer layer |
2.5/2.5mil (H/H OZ base copper) |
|
|
8 |
孔到内层导体最小间距 Min spacing between hole to inner layer conductor |
6mil |
|
|
9 |
孔到外层导体最小间距 Min spacing between hole to outer layer conductor |
6mil |
|
|
10 |
最小过孔焊环 Min annular ring for via |
3mil |
|
|
11 |
最小元件孔焊环 Min annular ring for component hote |
5mil |
|
|
12 |
最小BGA 焊盘 Min BGA diameter |
8mil |
|
|
13 |
最小BGA pitch Min BGA pitch |
0.4mm |
|
|
14 |
最小成品孔径 Min hole size |
0.15mm(CNC)|0.1mm(Laser) |
|
|
15 |
最大板厚孔径比 Max aspect ratios |
20:1 |
|
|
16 |
最小阻焊桥宽 Min soldermask bridge width |
3mil |
|
|
17 |
阻焊/线路加工方式 Soldermask/circuit processing method |
菲林|激光直接成像 Film|LDI |
|
|
18 |
最小绝缘层厚 Min thickness for insulating layer |
2mil |
|
|
19 |
HDI及特种板 HDI & special type PCB |
HDI(1-3 steps)|R-FPC(2-16 layers)|High frequency mix-pressing(2-14 layers)|Buried capacitance & resistance …… |
|
|
20 |
表面处理类型 Surface treatment type |
化学沉金|有铅/无铅喷锡|OSP|沉锡|沉银|镀厚金|镀银 ENIG|HAL|HAL lead free|OSP|Immersion Sn|Immersion silver|Plating hard gold|Plating silver |
|
|
21 |
最大加工尺寸 Max PCB size |
609*889mm |
|
|
|
|||
 中文
中文 English
English






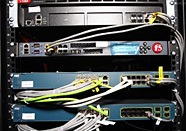



 电话:183 2094 0620
电话:183 2094 0620

